原子層沉積系統 (Atomic Layer Deposition, ALD)
最後更新日期 :
2021-08-11
設備原理:
原子層沉積(Atomic Layer Deposition, ALD)係藉由表面獨特自我侷限反應來成長高階梯覆蓋與大面積均勻性之薄膜。可用於奈米級或原子級薄膜沉積,調控超薄薄膜優異特性之先進鍍膜技術。然而傳統的原子層沉積系統為了使金屬前驅物完全反應,需較高基板溫度來提供成長薄膜時,前驅物反應所需之能量,故不利後續元件製程。我們建置的電漿輔助原子層沈積(Plasma Enhanced ALD, PEALD)則藉由高能電漿輔助之特性,可不受前驅物反應溫度之限制,於低溫成長高緻密性、及低雜質的高品質薄膜,改善半導體與光電元件日益微縮化的需求。傳統的CVD與PVD鍍膜技術所形成的薄膜缺陷密度高,無法形成緻密連續性的薄膜,對於結構性的元件其厚度均勻性與階梯覆蓋率不佳。原子層沉積具有高緻密性、高厚度均勻性、高階梯覆蓋率、低溫製程與原子級膜厚控制等特點。
目前已開發的電漿輔助原子層沉積以TEMAH(四(乙基甲胺基)鉿)及TEMAZ(四(乙基甲胺基)鋯)前驅物(precursors)為主的高介電常數材料HfO2、ZrO2、或其混和摻雜高介電金屬氧化物(High-k materials)。

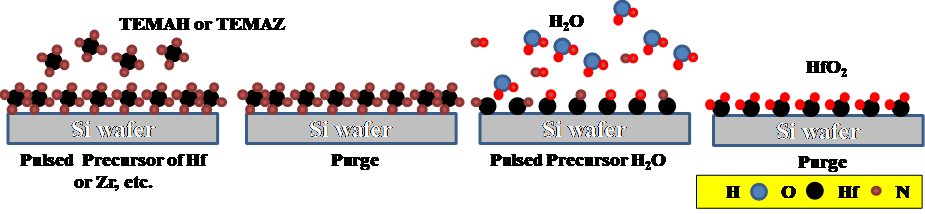
規格:
1. 試片區域為4吋晶圓大小。
2. 腔體製程最高溫度:200 ℃。
3. 目前以沉積氧化物薄膜為主,可提供前驅物製作HfO2、ZrO2薄膜。
4. 使用的氣體包括:Ar、O2、PN2等。
5. 電漿使用瓦數範圍:0~500w
瀏覽數:
分享
