高密度電漿輔助化學氣相沉積系統 (Inductively Coupled Plasma-Chemical Vapor Deposition, ICP-CVD)
最後更新日期 :
2021-08-10
設備原理:
因ICP之耦合方式係藉由磁場所產生,由電磁理論得知其電場,即離子加速方向,是以環繞此一磁場且平行於晶圓表面之切線方向,所以當輸入之功率(通常以RF之頻率為主)加大時,磁場與電場皆相對增加,電漿內之離子加速方向,因平行於晶圓表面之切線方向,因此較不易對晶圓產生損傷。基於此一優點,ICP的輸入功率可以達到相當高的範圍。以能量損耗之觀點來看,在ICP的電漿系統內,由於離子加速路徑是環繞著磁力線而行,離子循著電場方向加速而撞擊反應器之內壁或晶圓表面,而造成能量損失的機率非常低。在此狀況下,離子可以週而復始的在反應腔內部進行向心加速作用,而增加相互碰撞的機率。由於粒子之間碰撞機率的增加,所能產生離子的效率相對提高。在ICP系統內電漿之密度可高達1011/cm3的數量級以上,而傳統型的電漿密度約只有109/cm3的數量級,因此高密度電漿為ICP CVD的最大優點。
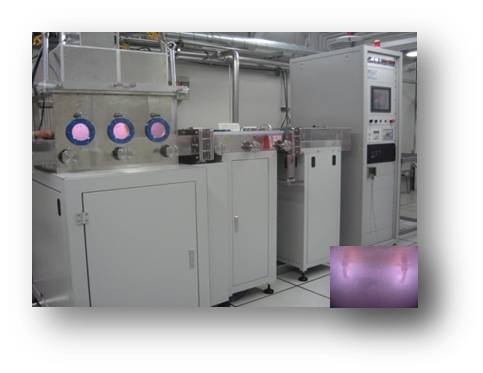
規格:
1. 可使用基板最大尺寸 : 250*250 (mm)。
2. 腔體溫度:500 ℃。
3. 用以沉積矽基與氧化物與氮化物薄膜。可提供a-Si、μC-Si、P-doped a-Si、N-doped a-Si、SiO2及Si3N4等薄膜沈積。
4. 使用的氣體包括:Ar、O2、N2、CF4、SiH4、H2、PH3、B2H6等。
瀏覽數:
分享
