批次-物理氣相沉積系統(Batch Type Physical Vapor Deposition)- 為多方位三維沈積系統
設備原理:
批次式物理氣相沉積系統使用四支5 吋X 12吋長方形靶槍,並由兩台脈衝直流電源與兩台射頻電源提供靶槍電源,基材並輔以直流電源作為偏壓。濺鍍試片置於四靶槍中間的基材放置架上,可做各種角度的公轉與自轉控制,因此可在具有三維形貌的元件上鍍製各種薄膜。本系統並搭配電漿放射監控裝置(Plasma emission monitoring, PEM),透過監控特定光譜訊號之強度變化來回饋控制製程氣體的流量,因而進一步獲得預期之薄膜品質。因此透過本設備將可研究離子束輔助沉積技術、脈衝直流電源技術以及相關製程參數對電漿密度與薄膜特性的影響。

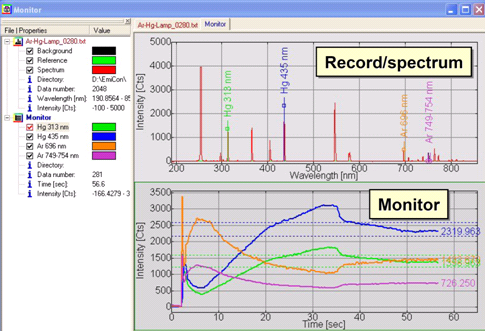
左圖:電漿放射監控裝置(PEM)示意圖。右圖:監控訊號包括光譜圖(Record /spectrum)與特定波長光譜強度與時間變化圖。從光譜譜強度之變化可以確知鍍膜製程的穩定性性。
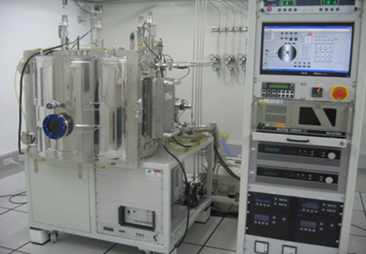
設備規格:
1.腔體尺寸: Φ660(D) x 600(H) mm。
2.使用四支5 *12吋矩型水冷磁控濺鍍靶槍,並由兩台脈衝直流電源(5000W)與兩台射頻電源(2000W)提供靶槍電源。
3.具有密封盤狀4吋真空加熱器,試片可間接加熱至450oC。採自動夾持加熱。
4.具有VAT PM5 自動壓力控制器與自動壓力節流閥系統。
5.試片可施以直流電源偏壓。
6.採三維立式自轉支柱設計,具有試片承接基座旋轉機制,包括Φ500 mm公轉盤(公轉速率:5~30 rpm) 及四組Φ150mm自轉載台(自轉速率: 20~40 rpm)。
7.濺鍍試片置於四靶槍中間之載台上,可同時控制公、自轉速率,能在三維形貌元件上鍍製各種薄膜。
設備功能:
1.具有電漿監視及製程控制系統,可即時監控電漿狀態。
2.具有直流脈衝電源,可增強電漿離子化程度與改善薄膜品質。
3.可進行金屬薄膜、金屬玻璃薄膜、合金薄膜、氮化物薄膜、氧化物薄膜、碳化物薄膜與、碳氮化物薄膜與氮氧化物薄膜之研究。
